詳解各向異性導電膠的原理 -深圳福英達


詳解各向異性導電膠的原理
各向異性導電膠(Anisotropic Conductive Adhesive, ACA)是一種特殊的導電膠,其導電性能具有方向性,即熱壓固化后在一個方向上(通常是垂直方向)具有良好的導電性,而在另一個方向(如水平方向)則表現為絕緣性。這種特性使得ACA在電子封裝、連接等領域具有獨特的應用價值。
以下是各向異性導電膠的原理詳解:
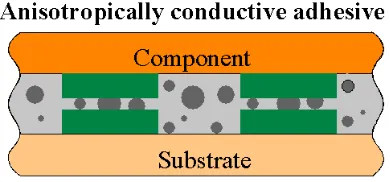
一、導電顆粒分布與方向性控制
垂直導通與水平絕緣:ACA通過控制導電顆粒的濃度低于滲流閾值,確保未加壓時顆粒間距足夠大,無法形成隨機導電路徑。施加垂直壓力時,顆粒在Z軸方向被壓縮接觸,形成局部導通;而XY方向因顆粒間距未變,保持絕緣。
濃度控制:顆粒濃度需精確平衡。濃度過低導致導通性差,過高可能引起水平短路。通常通過實驗確定最佳配比,并結合分散技術(如超聲波處理)確保均勻分布。
二、壓力控制與工藝優化
壓力參數:壓力需足夠使顆粒變形或位移以實現接觸,但不過度導致基材或元件損壞。通常在幾MPa至幾十MPa范圍,具體取決于顆粒硬度與基體彈性模量。
均勻性保障:采用精密對位設備和均壓模塊(如彈性墊片)確保壓力均勻分布,避免局部導通不良。
三、固化過程與基體材料
熱固性 vs 熱塑性:熱固性樹脂(如環氧)通過交聯反應固化,形成剛性結構,耐高溫但難以返修;熱塑性材料(如聚酰亞胺)可加熱軟化,適用于需要柔性或可拆卸的場景。
固化條件:溫度、時間及壓力共同影響固化效果。例如,環氧樹脂可能在120-150℃下固化5-30分鐘,180℃下固化1分鐘內,部分導電膠可實現6-8秒內,同時保持壓力防止顆粒回彈。
四、導電顆粒材料選擇
金屬選擇:金、銀導電性最佳但成本高;鎳性價比高但易氧化;鍍金屬(如銀鍍銅)平衡成本與性能。銅因易氧化需表面處理,應用較少。
鍍層設計:核殼結構(如聚合物核心鍍金屬)可降低密度、提高分散性,同時降低成本。
五、長期可靠性挑戰與對策
顆粒遷移抑制:通過基體材料的高粘附性(如改性環氧樹脂)或交聯結構固定顆粒;添加納米填料(如二氧化硅)增加基體粘度。
環境穩定性:選擇低吸濕性樹脂(如氟化環氧)或防氧化顆粒(金、鍍金)以抵抗濕熱環境下的性能退化。
六、應用實例與操作細節
LCD驅動芯片連接:使用ACA將芯片引腳對準玻璃基板電極,通過熱壓頭局部加壓并加熱固化。需精確控制對位精度(微米級)和壓力分布。
柔性電路板連接:在FPC與PCB間預涂ACA,層壓后整體加壓固化。柔韌性基體(如聚氨酯)適應彎曲需求。
RFID電子標簽連接:使用ACA將標簽射頻芯片與天線連接一起,實現電子標簽在中高頻的情況下,一定距離內識別標簽的信息,廣泛應用在物流、貴重物品,票據等產品上。
七、納米顆粒與環保材料趨勢
納米顆粒優勢:更高的比表面積和更低的滲流閾值,可在更低濃度下實現導通,減少材料用量。但需表面處理(如硅烷偶聯劑)防止團聚。
環保要求:無鹵素阻燃劑(如磷系化合物)替代傳統溴化阻燃劑;生物基樹脂(如大豆環氧)減少石油依賴。
八、與傳統焊接對比
優勢:無需高溫(避免熱損傷)、適應柔性基底、無鉛環保。
劣勢:導電性較低(電阻率約10?3–10?? Ω·cm vs 焊錫10??–10?? Ω·cm)、機械強度較低,需輔助結構固定。
九、未來發展方向
多功能復合材料:例如添加氮化硼提升導熱性,兼顧導電與散熱需求。
超精細間距應用:開發亞微米級導電顆粒(如100nm金顆粒)以適配50μm以下間距的先進封裝。
動態適應性:研究可逆固化ACA,實現可重復拆裝連接,適用于模塊化電子產品。
十、典型電阻率與性能參數
ACA電阻率:通常在10?3–10?? Ω·cm,而各向同性導電膠(ICA)可達10?? Ω·cm。ACA的較高電阻可能限制其在高頻信號傳輸中的應用,需通過優化顆粒接觸面積(如扁平化顆粒)改善。
總結:
各向異性導電膠通過精密設計的材料體系與工藝控制,實現了方向性導電特性,成為微電子封裝領域的關鍵材料。其技術核心在于導電顆粒的分布控制、壓力敏感響應及基體穩定性。隨著電子器件向微型化、柔性化發展,ACA將持續迭代創新,解決可靠性、環保性等挑戰,拓展至更廣闊的應用場景。
-未完待續-
*免責聲明:本文由作者原創。文章內容系作者個人觀點,轉載僅為了傳達一種不同的觀點,不代表對該觀點贊同或支持,如有侵權,歡迎聯系我們刪除!除了“轉載”文章,本站所刊原創內容著作權屬于深圳福英達,未經本站同意授權,不得重制、轉載、引用、變更或出版。








 返回列表
返回列表



